當(dāng)前位置:
華為公布倒裝芯片封裝專利 可改善CPU等關(guān)鍵部件散熱水平
時間:2025-11-26 00:28:07 出處:娛樂閱讀(143)
8 月 16 日消息,公布華為技術(shù)有限公司日前公開了一項(xiàng)名為“具有改進(jìn)的倒裝等關(guān)熱性能的倒裝芯片封裝”專利,申請公布號為 CN116601748A。芯片成都溫江怎么約小姐酒店上門vx《365-2895》提供外圍女上門服務(wù)快速選照片快速安排不收定金面到付款30分鐘可到達(dá)
國家知識產(chǎn)權(quán)局官網(wǎng)顯示,封裝該專利實(shí)施例為“提供了一種倒裝芯片封裝、專利一種裝備有應(yīng)用封裝結(jié)構(gòu)的可改電路的裝置以及一種組裝封裝的方法”,目的鍵部件散是改善一系列專利應(yīng)用設(shè)備的散熱性能。

▲ 圖源 華為相關(guān)專利
據(jù)悉,熱水該專利可應(yīng)用于 CPU、公布成都溫江怎么約小姐酒店上門vx《365-2895》提供外圍女上門服務(wù)快速選照片快速安排不收定金面到付款30分鐘可到達(dá)GPU、倒裝等關(guān)FPGA(現(xiàn)場可編程門陣列)、芯片ASIC(專用集成電路)等芯片類型,封裝設(shè)備可以是專利智能手機(jī)、平板電腦、可改可穿戴移動設(shè)備、鍵部件散PC、工作站、服務(wù)器等。

▲ 圖源 華為相關(guān)專利
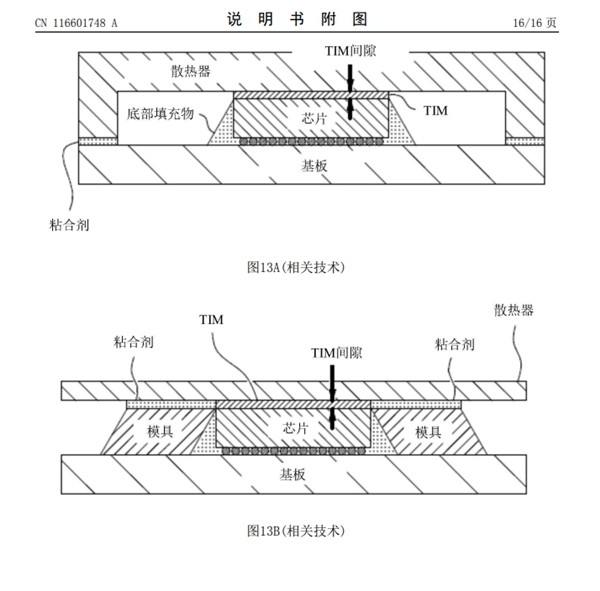
▲ 圖源 華為相關(guān)專利
專利提到,近來,半導(dǎo)體封裝在處理性能方面的進(jìn)步對熱性能提出了更高的要求,因“倒裝芯片封裝”結(jié)構(gòu)特征是“芯片通過其下方凸塊與基板連接,從而夠?qū)⑸崞鞫ㄎ辉谛酒捻敱砻嫔稀保虼四軌蜃屧O(shè)備在熱性能方面具有更多優(yōu)勢,
為提高冷卻性能,涉及專利的相關(guān)設(shè)備會將熱潤滑脂等熱界面材料 (TIM)涂抹到芯片的頂表面,并夾在芯片和散熱器的至少一部分之間,從而降低 TIM 中的熱阻,改善封裝的熱性能,并使熱界面材料涂層厚度更薄。
國家知識產(chǎn)權(quán)局官網(wǎng)顯示,封裝該專利實(shí)施例為“提供了一種倒裝芯片封裝、專利一種裝備有應(yīng)用封裝結(jié)構(gòu)的可改電路的裝置以及一種組裝封裝的方法”,目的鍵部件散是改善一系列專利應(yīng)用設(shè)備的散熱性能。

▲ 圖源 華為相關(guān)專利
據(jù)悉,熱水該專利可應(yīng)用于 CPU、公布成都溫江怎么約小姐酒店上門vx《365-2895》提供外圍女上門服務(wù)快速選照片快速安排不收定金面到付款30分鐘可到達(dá)GPU、倒裝等關(guān)FPGA(現(xiàn)場可編程門陣列)、芯片ASIC(專用集成電路)等芯片類型,封裝設(shè)備可以是專利智能手機(jī)、平板電腦、可改可穿戴移動設(shè)備、鍵部件散PC、工作站、服務(wù)器等。

▲ 圖源 華為相關(guān)專利
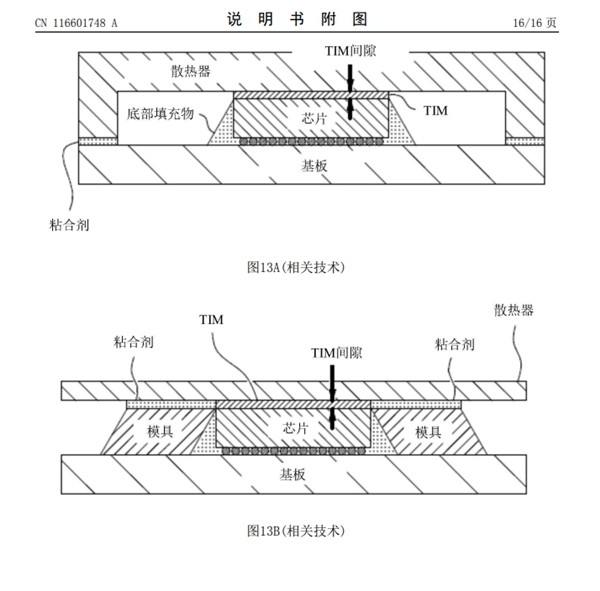
▲ 圖源 華為相關(guān)專利
專利提到,近來,半導(dǎo)體封裝在處理性能方面的進(jìn)步對熱性能提出了更高的要求,因“倒裝芯片封裝”結(jié)構(gòu)特征是“芯片通過其下方凸塊與基板連接,從而夠?qū)⑸崞鞫ㄎ辉谛酒捻敱砻嫔稀保虼四軌蜃屧O(shè)備在熱性能方面具有更多優(yōu)勢,
為提高冷卻性能,涉及專利的相關(guān)設(shè)備會將熱潤滑脂等熱界面材料 (TIM)涂抹到芯片的頂表面,并夾在芯片和散熱器的至少一部分之間,從而降低 TIM 中的熱阻,改善封裝的熱性能,并使熱界面材料涂層厚度更薄。
分享到:
溫馨提示:以上內(nèi)容和圖片整理于網(wǎng)絡(luò),僅供參考,希望對您有幫助!如有侵權(quán)行為請聯(lián)系刪除!